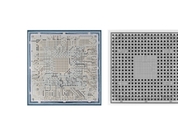
확보한 기술로 국내외 AI, 메모리 수요 업체와 사업화 기회 발굴할 계획 네패스가 'FOWLP를 이용한 3D IC 제조를 위한 핵심 소재 및 공정 기술 개발'을 완료했다. 네패스와 합동 연구단은 고성능 인공지능 반도체에 적용 가능한 3D 집적화 패키징 기술, 핵심 소재 및 테스트 솔루션 완성했다고 밝혔다. 해당 과제는 네패스가 총괄을 맡아 2018년부터 약 5년간 진행됐다. 특히, 이번 연구는 첨단 반도체 핵심 기술 개발을 통해 대한민국 반도체 산업의 발전과 첨단 후공정 플랫폼 경쟁력을 확보한다는 목표로 마이크로프랜드, 켐이, 한국전자기술연구소, 서울테크노파크, 재료연구소, 서울과학기술대학교, 덕산하이메탈 등 다수의 기관이 컨소시엄에 참여해 시작됐다. 한국은 메모리 산업은 글로벌 선두에 있지만 그 2배 이상 규모인 비메모리 시장에서는 점유율 3% 이하로 영향력이 미미한 상태다. 대한민국이 진정한 반도체 강국이 되려면 반도체의 핵심 공정인 첨단 패키징 기술 확보와 반도체 산업 생태계를 육성하는 방향으로 전략을 수립해야 한다는 목소리가 높아지고 있다. 이에 연구진은 AI, 로봇, IoT 등 응용 산업 전반 영역에서 수요가 급증하는 고성능 반도체의 지능화, 저전력

[첨단 헬로티] 네패스의 'FOWLP 기술을 활용한 핵심소재와 공정기술 개발'과제가 정부지원을 받는 국책과제로 선정됐다. 네패스는 총괄주관기관, 세부주관기관으로서 3D IC 제조를 위한 소재 개발과 FO PKG를 이용한 인공지능 3D 칩 제조공정 기술 개발 등의 세부과제를 총괄한다. 네패스는 FOWLP, WLP 등 반도체 패키징에 대한 선행 기반기술 및 리더쉽을 확보하고 있어 기술개발 가능성이 높으며, FOWLP 기술의 향후 전망성이 높아 기술개발 성공 시 비메모리 분야로 성장 가능성이 높을 것으로 평가받으며 동 과제에 최종 선정됐다. 반도체 FOWLP 패키징 기술 총괄주관책임자인 김종헌 전무는 "본 과제는 국가에서 차세대 성장 동력인 인공지능이 결합된 첨단 반도체 부품 기술·소재 개발을 지원하는 대형 국책사업"이라며, "네패스가 핵심 성장동력으로 역량을 집중하고 있는 AI반도체와 첨단 부품 기술인 팬아웃패키징 사업에도 가속도가 붙을 것으로 기대한다"고 전했다. 이어서 김 전무는 국내 시스템 반도체 산업의 역량 강화 측면에서 '국내 중소·중견 기업 및 기관이 상생의 협업 모델을 만들고 인공지능 3D IC 생태계를 조성하는 것에 더 큰

[헬로티] TSMC 상용화 성공 후 애플의 적극적인 채용으로 가파른 성장 FOWLP 기술은 2009년부터 상용화가 시도됐다. 하지만 수율 확보의 어려움 때문에 대중화되지 못했으나 TSMC가 상용화를 성공한 후 애플이 적극적인 FOWLP를 적용하면서 빠르게 성장하고 있다. PCB 전문 시장조사기관인 PRISMARK에 따르면, FOWLP 시장 규모는 올해 4억 달러에서 2020년 17억 달러에 이르며 연평균 89% 성장할 전망이다. 수량 기준으로는 올해 4.4억 개에서 2020년 20억 개로 연평균 69% 성장할 전망이다. 애플이 고성능 Application Processor를 채택한 것을 계기로 향후 수년간 모바일 칩 중심으로 추종 수요가 강할 것으로 예상된다. 2011년부터 2015년까지 FOWLP 시장은 연평균 5% 성장하는데 그쳤고, 시장 규모도 연간 1억 달러 미만이었다. 그러다가 TSMC가 차별적인 InFO(Integrated Fan-Out) 솔루션을 통해 양산성을 확보하는데 성공했고, 애플의 A10 Processor를 거의 독점적으로 생산하기로 하면서 시장이 급변하고 있다. 그림 1과 그림 2에서 보듯이 매출액 기준으로는 AP를 비롯해 I/O cou

[헬로티] 후공정인 패키징 원가 낮추고, 반도체 고성능화에 따른 기술 변화 이끌어 현재 패키징 산업은 궁극적으로는 SIP와 원칩 모듈로 가는 과정에 있다. 현재는 시스템이 잘못되면 검증하고 PCB를 만드는 개발 과정을 다시 거쳐야 하는데, SIP나 원칩 모듈 수준까지 시장이 발전하면 제품 개발 리드타임을 크게 줄여 원가를 낮추게 됨은 물론, 두께와 부피도 대폭 줄일 수 있게 된다. 그리고 이러한 큰 흐름 속에서 FOWLP가 기존 패키지 시장을 대체할 게임 체인저로 부각되고 있다. 그 동안의 반도체 패키징은 에폭시 몰딩 컴파운딩형 패키징, PCB기반의 패키징이 일반적 형태였다. 국내 대기업의 모바일 반도체 패키징 역시 PCB기반 패키징으로, PCB 기반 AP (Application Process)를 북미 모바일 업체에 공급해온 바 있다. 그러나 점점 반도체가 다기능화 되면서 요구되는 핀(pin) 수가 많아지고 이에 따라 패키징 사이즈가 커지게 되었는데, 이에 따라 모바일, 웨어러블 디바이스 등의 제품이 추구하는 ‘경박단소’ 트렌드에 부합하는 패키징 니즈가 발생하게 됐다. 이러한 수요를 충족시키기 위해 개발된 기술이 Wafer Level P

▲ FOWLP 관련 출원인 국적에 따른 연도별 출원 동향 [사진=특허청] [헬로티] 얇고 가벼운 고사양 휴대용 전자기기의 수요가 증가하면서 반도체 패키지를 소형화시켜주는 FOWLP(Fan-Out Wafer Level Package) 기술의 특허출원이 증가하고 있다. FOWLP 기술은 칩 배선에 필수적으로 사용되어 온 인쇄회로기판(PCB)을 사용하지 않고 칩과 칩 바깥 영역의 입출력 단자를 상호 연결하기 때문에 반도체 패키지가 얇아지고 배선길이가 짧아지고 방열 기능이 향상되며 신호 전송도 효율적으로 이뤄지게 되는 장점이 있다. 특허청에 따르면, 2007년부터 2014년까지 FOWLP 기술과 관련하여 모두 177건이 특허출원됐다. 특히, 2014년에는 전년 대비 2배 가까운 특허출원이 되는 등 급증세를 보이는 것으로 조사되었다. 국가별 동향을 살펴보면 우리나라의 특허출원이 가장 많은 것으로 조사됐으나 최근에는 스마트폰용 반도체 칩 생산에 뛰어든 인텔과 아이폰7 핵심 반도체 부품을 제조한 TSMC의 영향으로 미국과 대만의 특허출원이 급증했다. 이처럼 한국, 미국, 대만 등 각국 기업이 FOWLP 기술에 관한 특허출원을 늘려나가고 있어 FOWLP 기술을 둘러싼 국내